关于电阻率测量的一切
内容概览
目录
涡流传感器电阻率测量
涡流测量仪和传感器通常应用于许多行业的电导率和电阻率测量。大多数系统以接触方式运行,但也提供非接触式选项。使用涡流法的原因多种多样,下面列出了其中一些:
- 高重复性和高精度
- 易于自动化
- 不受表面形貌影响 / 可在粗糙表面测量
- 接触和非接触模式(首选与样品的恒定距离)
- 穿透氧化层测量 / 穿透封装层测量
- 传感器探头易于应用
- 实时测量 / 超快速(20 毫秒/次测量)
- 无磨损或低磨损
- 测量范围大
- 穿透深度低,适用于极薄材料的表征
通过对其体特性的评估,可从样品中获取直接和间接信息
- 成分监测
- 材料类型 / 分拣
- 纯度监测
- 掺杂监测
- 机械性能监测
- 晶粒结构变化
- 应力变化
- 硬度变化
- 缺陷监测
- 裂纹
- 腐蚀 / 氧化等表面缺陷
用于电阻率测试的仪器和传感器包括手持式、台式、成像式以及用于自动化测试设置的涡流传感器集成套件。
描述电阻率的定义和单位
电阻 (R) 是一个电学量,描述了材料、一系列材料或材料截面如何减少流经它的电流。欧姆定律指出,流经导体的电流 (I) 与电位差 (V) 成正比,与电阻 (R) 成反比。电阻的测量单位是欧姆,用希腊字母 omega (Ω) 表示。它以德国物理学家格奥尔格·西蒙·欧姆(Georg Simon Ohm,1784-1854 年)的名字命名,他研究了电压、电流和电阻之间的关系。
体电阻率(ρ,rho)是一种体属性,这意味着其数值不取决于特定样品的尺寸或形状。它仅取决于材料本身。体电阻率表示样品单位体积的电阻,也称为体积电阻率或比电阻。该术语通常用于材料表征和分类。每种材料都有唯一的体电阻率特征值。其单位通常以 [Ω∙cm] 或 [Ω∙m] 表示。
表面电阻 (Rs) 或更常用的方块电阻,是样品单位表面的电阻。材料的电阻和电阻率通过其尺寸或横截面电阻相互关联。可以描述为:

电阻是一种外在属性(取决于其几何形状),而电阻率是一种内在属性(独立于其几何形状)。从技术上讲,两者的单位相同,都是欧姆。为了将其与电阻区分开来,记作 Ω/□ 或 Ω/sq。请参阅我们的 方块电阻章节 以获取更多见解。
描述电导率的定义和单位
电导率 (σ, sigma) 与体电阻率成反比。它也称为比电导。单位是 S/cm 或 S/m。
电导 (G) 是衡量几何定义的材料(电阻器)在一定电压下传导电荷能力的指标。它是方块电阻的倒数。电阻的 SI 单位是欧姆 (Ω),而电导的测量单位是西门子 (S),等于 1/R。
电阻率测量方法
四探针法测量电阻率
如果材料厚度为半无限大,则体材料的电阻率可以通过四探针 (4PP) 法进行表征。Valdes 的实验设置 (L. B. Valdes, “Resistivity Measurements on Germanium for Transistors,” Proceedings of the IRE, 42(2), 420-427, 1954) 表明,如果探针间距乘以系数 5 小于材料厚度,则可以在不使用修正因子或考虑材料厚度的情况下得出电阻。
涡流法测量电阻率
与四探针法类似,如果样品的厚度大于感应电流的穿透深度,涡流法也能够确定电阻率。关键区别在于,即使使用非常小的探针间距,电流的穿透深度也比四探针设置小得多。穿透深度(即电阻率测量的分析区域)取决于多个因素。涡流穿透材料的深度受涡流频率、样品的电导率和磁导率的影响。以下公式用于其理论计算。

穿透深度随频率、电导率和磁导率的增加而减小。涡流密度下降到 1/e(或约表面密度的 37%)时的深度称为标准穿透深度(d 或 1d),并被用作研究体材料的理想测量标准。在三个标准穿透深度 (3d) 处,涡流密度仅为表面密度的 5%。更多详情请见我们的 技术选择。
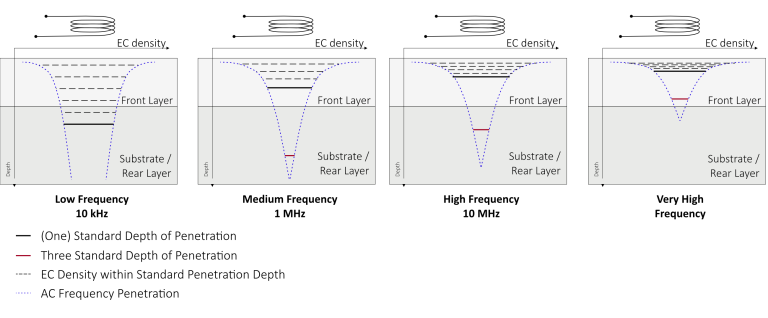
介电常数(Permittivity)也被称为电容率。介电常数描述了电介质在电场中储存静电能的相对能力。材料的相对介电常数越小,绝缘性能越好。当介质被施加电场时,会产生感应电荷以削弱电场。原始施加电场(真空中)与最终电场的比值称为介电常数,它也与频率有关。
半导体电阻率
晶圆的硅电阻率因半导体类型和掺杂水平、其制造工艺、晶圆在晶棒中的位置以及晶圆本身而异。几十年来,制造商一直试图改善从中心到边缘的电阻率波动。尽管如此,电阻率波动仍然存在,可以通过晶圆电阻率涡流成像进行有效监测。相关材料包括具有 p 型和 n 型掺杂的单晶和多晶晶圆,特别是在光伏行业,还包括 SiC、GaN 和硅晶圆、晶锭或晶棒。工艺表征包括生长/创建、注入、退火。
晶圆电阻率表征
硅晶圆 可以是无掺杂或 p 型和 n 型掺杂的单晶和多晶材料。下图显示了晶体硅中电阻率对硼和磷/砷掺杂浓度的依赖关系,其中掺杂硼 (B) 产生 n 型半导体材料,掺杂磷 (P) / 砷 (As) 产生 p 型半导体材料。涡流传感器用于测量晶圆的方块电阻,PN 测试仪用于确定掺杂类型,电容传感器或光学传感器用于确定其厚度。
碳化硅 (SiC) 作为一种材料,因其在高温下的特性、快速开关性能和 PN 结的高击穿电压而表现出色,这支持了使用更高电压的紧凑型组件。SiC 晶圆的电阻率成像用于检测和表征材料刻面和其他缺陷(如位错)。SiC 晶圆的电阻率可低于 1 Ohm cm,最高可达 Ohm cm,具体取决于掺杂水平。通过大量掺杂硼、铝或氮可实现金属电阻率。在 1.5 K 的温度下,在 3C-SiC:Al、3C-SiC:B 和 6H-SiC:B 中观察到了超导性。涡流传感器用于晶圆和晶锭监测。
GaN 晶圆 通常应用于 LED 和晶体管领域。全球范围内一直在努力通过外延工艺在广泛且廉价的硅晶圆上生产 GaN。然而,由于 GaN 和 SiC 的晶格常数和热膨胀系数差异很大,所应用的外延层具有挑战性,因为它们通常包含缺陷。电阻率成像支持整个加工链的表征过程。
晶棒或方块电阻率表征
晶棒内的电阻率因其制造工艺以及掺杂剂在晶圆块或晶棒内的分布而异。存在中心到边缘以及顶部到底部的变化。涡流传感器应用于可用表面以监测这种变化。良好的表面性能有助于获得良好的测量结果。
SiC 晶锭表征
一个相当新的应用是利用非接触式涡流传感器进行 SiC 晶锭表征。SiC 的电阻率揭示了纯度和晶粒结构的变化。涡流传感器用于分析 SiC 的成分、结构、位错区,并检测缺陷区并评估缺陷密度。此外,高频涡流传感器的电抗成像显示了注入工艺的有效性,并揭示了后续用于激活注入物的退火工艺的数量,并显示了进一步与温度相关的材料变化。
石墨烯表征
石墨烯作为一种单层碳 (C) 材料,因其卓越的电学、机械和光学性能而受到广泛研究。石墨烯层的高导电性使其在电子器件的许多方面具有巨大的应用潜力。石墨烯目前最有前途的应用是至少部分成为硅的可能替代品,制造超微型晶体管,用于生产未来超级计算机的处理器,由于应用了石墨烯,这些处理器的运行速度将快数百倍。石墨烯层有许多相关属性。方块电阻和电导不仅代表电学性能,还代表石墨烯样品的质量。电均匀性是表征制造工艺性能的重要指标。非接触式 SURAGUS 系统用于各种类型石墨烯的测量。它们的预期方块电阻值因石墨烯样品的规模、制造工艺和基底而异,这些样品将应用于不同的工业领域。
材料
在我们的材料数据库中可以找到包括金属、合金和半导体在内的完整材料列表及其各自的电阻率和电导率。
测量标准
- SEMI M87 — 半绝缘半导体非接触式电阻率测量测试方法
- SEMI MF673 — 使用非接触式涡流测量仪测量半导体晶圆电阻率或半导体薄膜方块电阻的测试方法
- ASTM F84-02 – 使用在线四探针测量硅晶圆电阻率的标准测试方法(2003 年撤回,无替代标准)
电阻率测量设备类型
便携式设备
用于单点测量
便携式涡流设备专为产品质量的快速随机抽检而设计——通常用于收货环节或在生产后检查特别大的部件。
要进行测量,请将设备放置在目标表面上。按下 “测量” 按钮,一秒钟内即可显示结果。
每次测量都在测试的特定点提供精确值——在灵活性和速度至关重要的地方提供即时、可靠的反馈。

台式工具
用于单点测量
我们的便携式系统是快速抽检测量的理想选择——无论是在收货环节、过程检验期间,还是对于固定设置不切实际的大尺寸部件。
只需将便携式单元放置在待测表面上,按下 “测量” 按钮,一秒钟内测量值就会出现在显示屏上。
每次读数都代表测量点的精确值——无论您在哪里需要,都能为您提供快速、可靠的反馈。

成像工具
用于全区域图像
我们的技术提供关于产品质量的高度详细的全表面信息——从而能够对工艺质量和稳定性得出有意义的结论。这些数据支持对制造工艺(如资源效率、吞吐速度)和产品本身(如提高均匀性、符合最低规格)进行有针对性的优化。
测量时,将样品放置在测量场的中心。预制支架(如用于晶圆的支架)可确保精确的中心定位。只需放入样品,关闭盖板,然后按下“开始测量”即可。
结果:由数千个单独测量点生成的整个层的高分辨率伪彩色图。这种可视化让您一目了然地获得可操作的见解。

在线系统
用于连续单点测量
我们的在线系统能够在生产步骤之前、期间或之后连续获取工艺质量和产品特性的数据。这种实时监控是生产自动化的基础,而生产自动化依赖于精确可靠的传感器数据。
系统无缝集成到您现有的生产线中。一旦操作员启动测量,所有数据都会自动记录并存储在中央数据库中。
根据系统配置,输出包括一个或多个线条轮廓——位于中心或跨层的关键点——实时提供对质量趋势和工艺稳定性的清晰洞察。

电阻率测量工具
研究机构和制造业在截然不同的应用中使用电阻率测试,对每天的测试次数、测量点密度和自动化程度有不同的要求。以下设备系列可供选择。
- 便携式
- 实验室/台式
- 单点
- 成像
- 在线/工具集成
